5D封装|EDA365:先进IC封装,你需要知道的几大技术( 二 )
2. 设计成本也不断上涨,每一代至少增加30~50%的设计成本
业界人士指出:此前迭代无需考虑新工艺问题,只需了解65nm比90nm小多少,可以直接把90nm上的设计拿到65nm工艺上,重新设计一下马上就能做,整个过程一年半载即可完成。但现在7nm和16nm有很多不一样的地方,不能把16nm的设计直接放到7nm上,从架构到设计到后端都要做很多改变。
异构集成类似于封装内系统集成(SiP);主要指将多个单独制造的部件封装到一个芯片上,而不是在单个衬底上集成多个基片。这增强了功能性,可以对采用不同工艺、不同功能、不同制造商制造的组件进行封装。通过这一技术,工程师可以像搭积木一样,在芯片库里将不同工艺的小芯片组装在一起。异构集成背后的总体思想是将在系统级别上变化的多个组件组合到同一个封装中。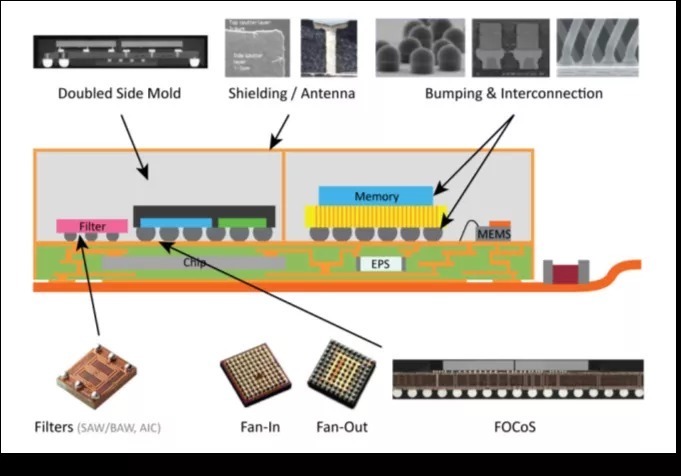
文章插图
不过,异构集成在延续摩尔定律的同时也面临可靠性、散热、测试难度等多方面的挑战。
高带宽存储器(HBM)
如今,GDDR5经过这么多年的发展已然来到了一个瓶颈,光靠频率提升来提供更大的显存位宽已经没有太大空间,而这势必会反过来影响到GPU的性能发挥。相对于传统的GDDR5显存来说,HBM无疑是更加先进。
HBM是一种标准化的堆叠内存技术,它为堆栈内以及内存和逻辑之间的数据提供了宽通道。基于HBM的封装将内存堆在一起,并使用TSV将它们连接起来,这样创建了更多的I/O和带宽。
HBM也是一种JEDEC标准,它垂直集成了多个层次的DRAM组件,这些组件与应用程序处理器、GPU和SoC一起在封装中。HBM主要在高端服务器和网络芯片的2.5D封装中实现;它现在已经发展到HBM2技术,新一代技术解决了原始HBM版本中的容量和时钟速率限制问题。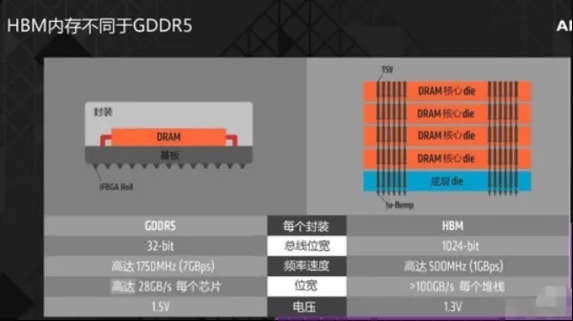
文章插图
这是一张AMD演示的内存架构图,我们可以清楚的看到HBM实际结构,尤其是四层DRAM叠在最底层die之上,虽然AMD一直也没有给出HBM本体的具体制作过程,但是不难想象4层绝不是HBM未来发展的极限,而随着层数的增加,位宽势必还会迎来进一步的递增。
文章插图
中介层
中介层用于多芯片模具或板子的封装,相当于一个导管,在一个封装里通过电子信号实现传导。通过中介层可以完成很多运算和数据交流,相当于连接多个芯片和同一电路板之间的桥梁。使系统更小,更省电,更大带宽。它可以将信号传播到更宽的中心间距,也可以将信号连接到主板上的不同沟槽上。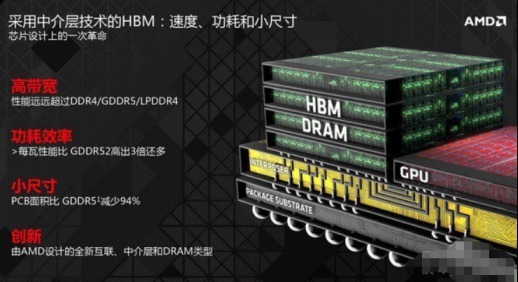
文章插图
【 5D封装|EDA365:先进IC封装,你需要知道的几大技术】
中介层可由硅和有机材料制成,作为多个模具、模具和基板之间的桥梁。Silicon interposer是一种成熟的技术,由于其较高的I/O密度和TSV形成能力,它在2.5D和3D IC芯片封装中发挥着关键作用。
再分配层(RDL)
再分配层是铜金属连接线或封装中电连接的一部分。再分配层是由金属或聚合物介质材料层创建,用于将模具堆叠在封装上,以及提供通过interposer连接的芯片之间的通信,从而减轻大型芯片组的I/O间距。它们已经成为2.5D和3D封装解决方案中不可或缺的环节。
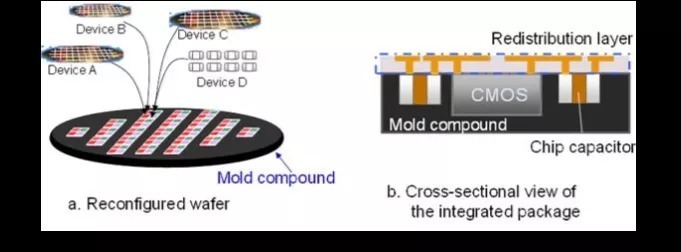
文章插图
硅通孔(TSV)
TSV是2.5D和3D封装解决方案中的关键实现技术,它提供了通过模具硅片的垂直互连。它在里面填充了铜。TSV是一种通过整个芯片厚度的电子连接,它可以创建从芯片一侧到另一侧的最短路径。
这些孔洞从晶圆片的正面蚀刻到一定深度,然后通过沉积导电材料(通常是铜)将它们隔离并填充。芯片制作完成后,晶圆从背面开始变薄,露出晶圆背面的孔和金属,以完成TSV互连。
文章插图
- 摩托罗拉|正式交付!首台2.5D/3D先进封装光刻机,24小时内中国收获两喜讯
- 京东方|京东方、TCL弯道超车?让OLED屏不伤眼,技术比三星、LG还先进
- 华为|比5G更让美国担心!这项技术确实“先进”,国产技术未来可期
- 开幕式|历史性突破,中国首台封装光刻机完成交付,西方没法卡脖子了
- 高通骁龙|为何要进口设备?清华大学半导体项目落地:国际先进、自主产权
- 酷睿处理器|Spring Boot 还是最先进的java框架吗
- 电子商务|老外不相信冬奥会技术先进?看到七大黑科技后,称这是我们的未来
- 华为|华为的企业文化理念怎么就这么先进
- Linux|OPPO与华为的铰链设计专利有什么区别?哪一个技术更先进?
- 封装|Apple Watch成功的关键!SiP封装前景光明
